来源:芯TIP
报告主题:从Wolfspeed角度看SiC MOSFET功率器件可靠性以满足特定应用要求
报告作者:DONALD A. GAJEWSKI
(DIRECTOR, RELIABILITY ENGINEERING & FAILURE ANALYSIS)
报告内容包含:(具体内容详见下方全部报告内容)
MOSFET的显著特征和器件级故障机制
可靠性 101
随时间变化的故障率:浴盆曲线
阈值电压稳定性
双极/体二极管的稳定性
栅极氧化层可靠性
反向偏置可靠性(HTRB)
湿度相关的可靠性
封装可靠性
功率循环
现场可靠性
行业联盟指南和标准
总结
报告详细内容

# SiC MOSFET的显著特征
# 器件级故障机制
栅极氧化层磨损(TDDB & HTRB)
VTH 稳定性 (NBTI/PBTI)
中子SEB耐性(CR)
双极不稳定性:BPDs/SFs(BDOL)
湿度:泄漏/腐蚀(H3TRB)
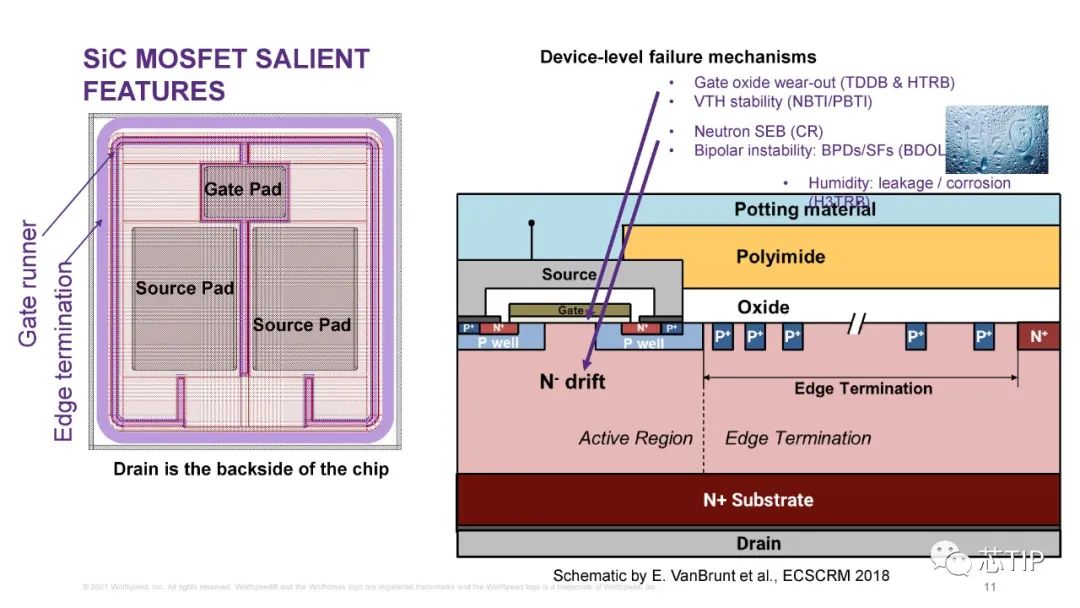
# 可靠性 101
随时间变化的故障率:浴盆曲线

# 阈值电压稳定性

# 阈值电压稳定性(PBTI 或 NBTI)
随时间变化的阈值电压偏移 (ΔVT) 可以改变导通状态和/或阻断特性
这可能发生在 Si 或 SiC MOSFET 中
ΔVT与界面和氧化物陷阱有关 (填充/排空/创建)
Si MOSFET 的 ΔVT取决于 MOS 栅极电场、温度和时间
SiC MOSFET 比 Si MOSFET 具有更多陷阱 ;VT稳定性更值得关注

# PBTI、NBTI 测试程序
(加热样品至测试温度,并保持 T 恒定)

# SiC 功率 MOSFET 的阈值电压稳定性 (PBTI, NBTI)
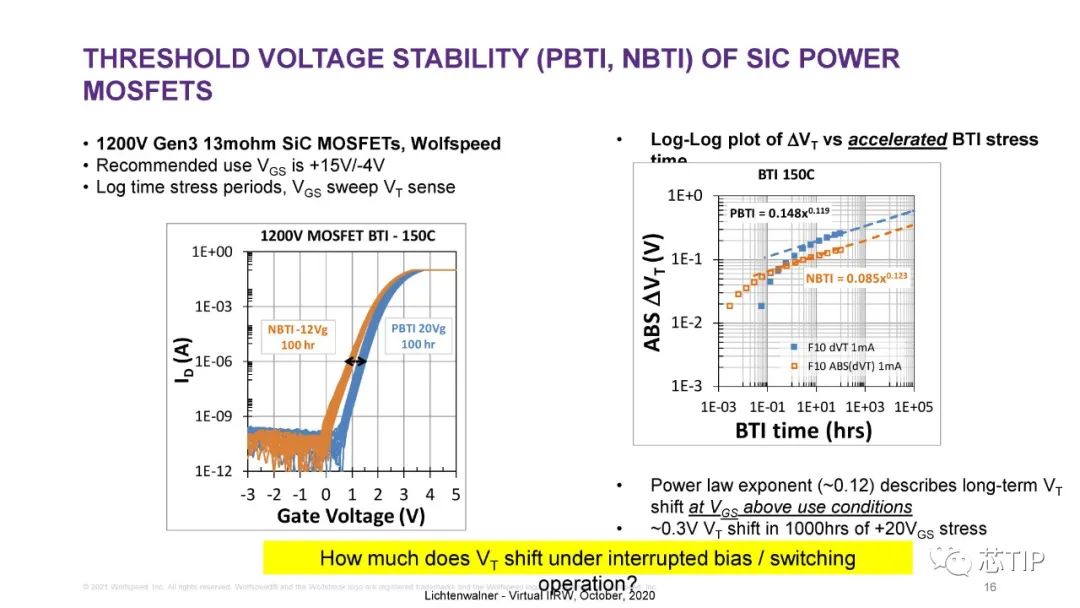
# PBTI/NBTI 恢复/切换效果
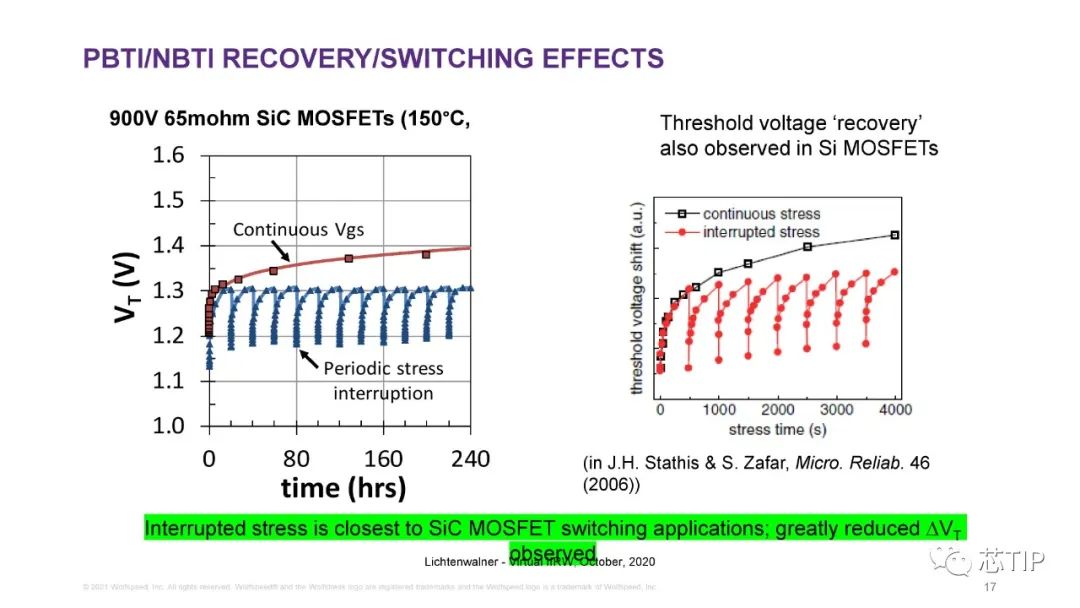
# 双极/体二极管的稳定性

# SiC 中的双极/体二极管稳定性
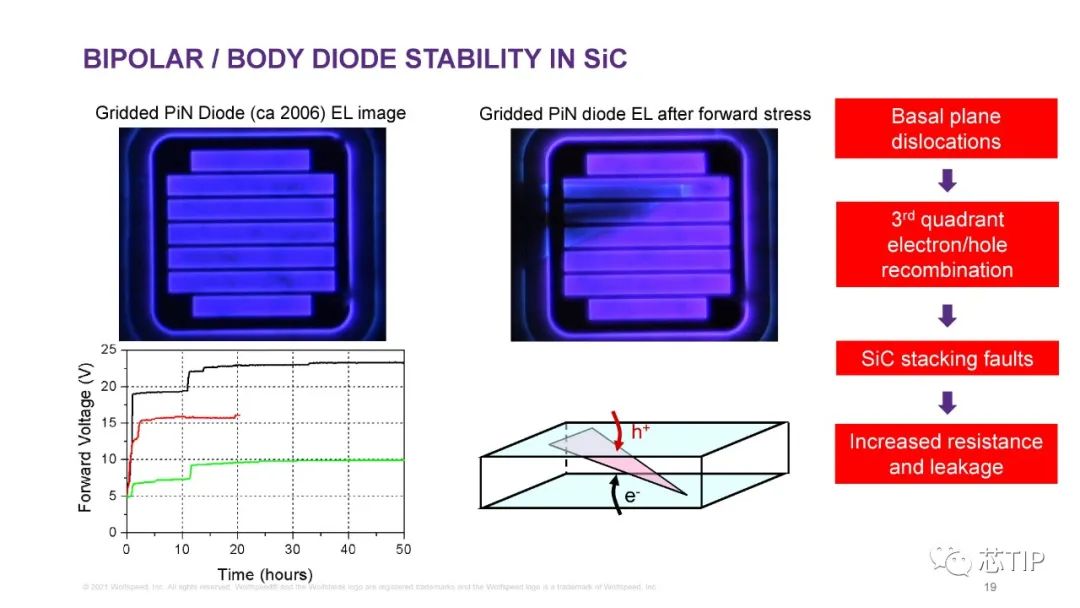
# 体二极管工作寿命 (BDOL):对 SiC MOSFET 的独特测试

# 为大功率耗散而设计的体二极管测试系统
• 3.3 kV MOSFET TJ测试期间:140 °C
• 3.3kV MOSFET 的认证测试耗散 6 kW
• 独立电路板提供温度监控和-5V 栅极驱动

# BDOL 测试显示在第三象限运行中完全稳定
61 个 3.3 kV 和 65 个 10 kV MOSFET 在 1000 小时内实现零故障

# BDOL:在应力检测后得到的任何设备参数中均未发生变化
未显示:
• MOSFET 阈值电压没有变化
• 在室温下,后测 VSD(体二极管电压)没有变化
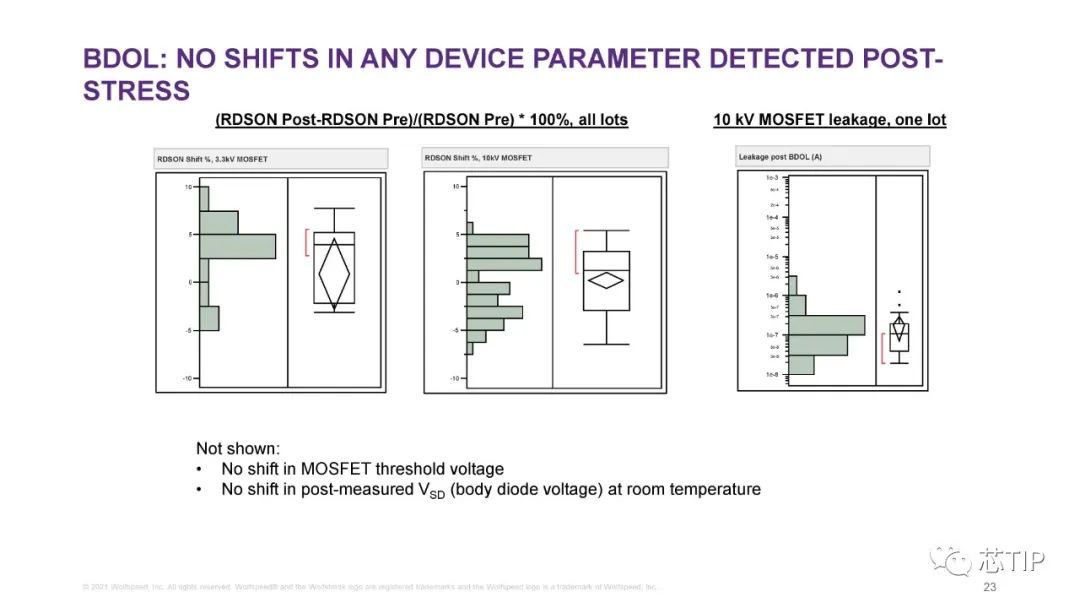
# 双极稳定性 – 可靠性影响
• 关于体二极管的重要说明:
– 如果 MOSFET 开始时没有任何 BPD,则堆垛层错不会成核和生长,也不会发生双极退化
– 因此,减少BPD的发生和筛查出BPD对于第三象限的可靠性非常重要!
• 可靠性影响:
- 相关文献基本表明,两极不稳定不能加速
– 没有已知的加速因素
– 没有已知的预测生命周期模型
– 幸运的是,大多数或所有故障都发生在 <~100 小时 BDOL 压力内
– 双极稳定性是一种早期寿命失效机制,而不是磨损
– 为确保低 PPM 和 ELRF,需要严重依赖:
› 测试大样本量
› 测试大型设备
› 测试更高电压的设备
› 在生产中对 BPD 进行积极和最先进的筛选

# 栅极氧化层可靠性

# 介质层时变击穿法(TDDB)
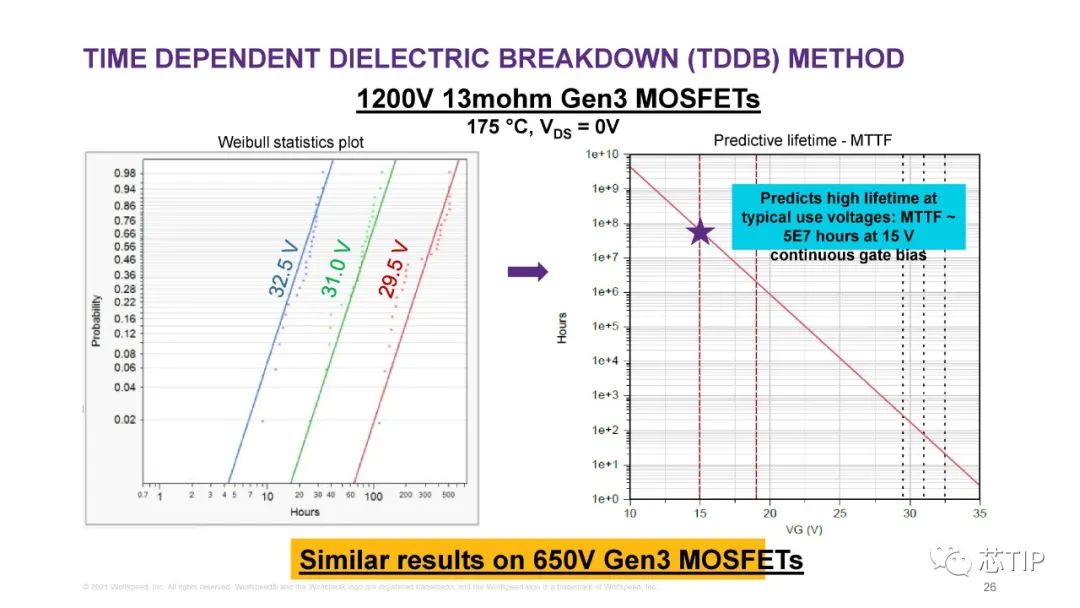
# 基于物理的预测生命周期建模
• TDDB 测试与温度和电压的关系,用于构建由 Joe McPherson(德州仪器可靠性研究员)发布的预测寿命模型:热化学模型 - 与Si MOSFET 使用的模型相同!
• 生成的模型参数与Si相似
- 在相同的电场下,平面MOSFET上的碳化硅栅极氧化物可靠性与Si MOSFET相当
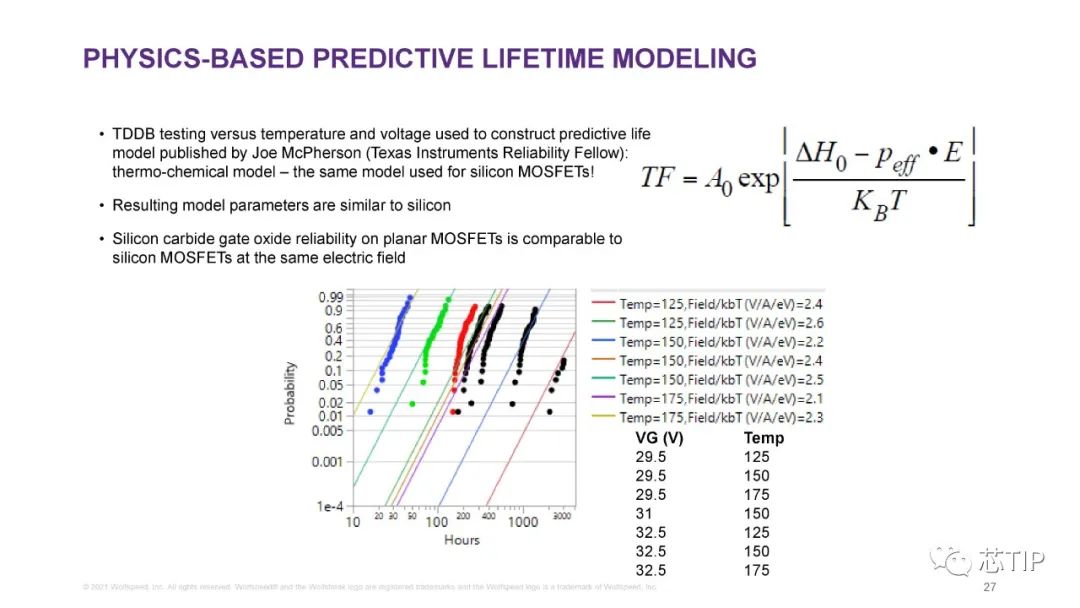
# 反向偏置可靠性(HTRB)

# 加速寿命测试高温反向偏置 (ALT-HTRB)
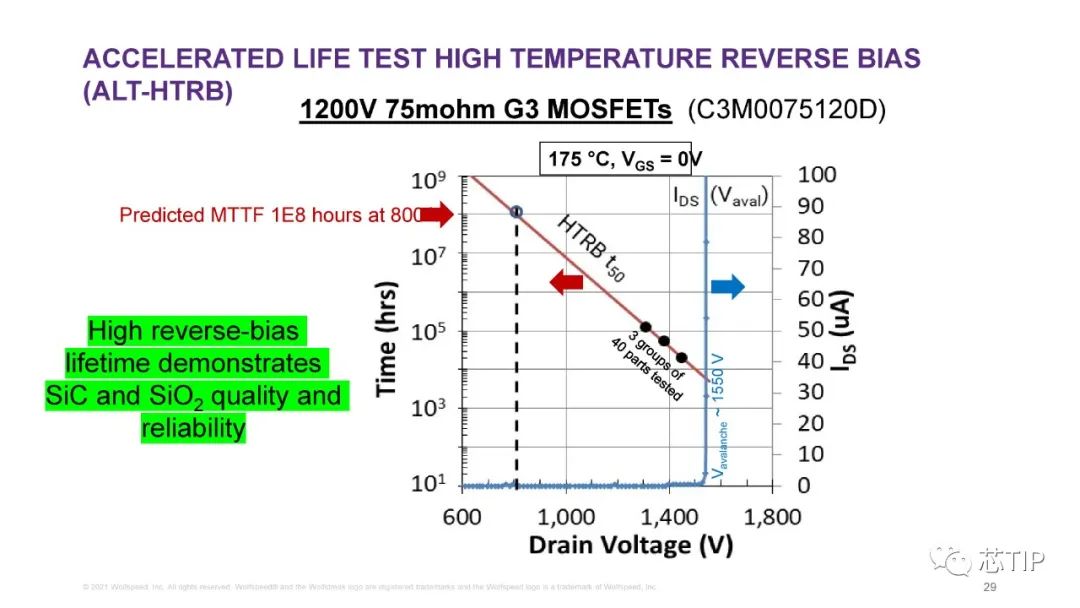
• 对于 Wolfspeed MOSFET,物理故障分析表明,故障是有源区的栅极氧化物击穿,在氧化物电场最高的 JFET 间隙中
• 故障分析未发现以下证据:
– 边缘终止击穿
– 碳化硅击穿
• 栅极氧化物磨损模型可用于寿命预测
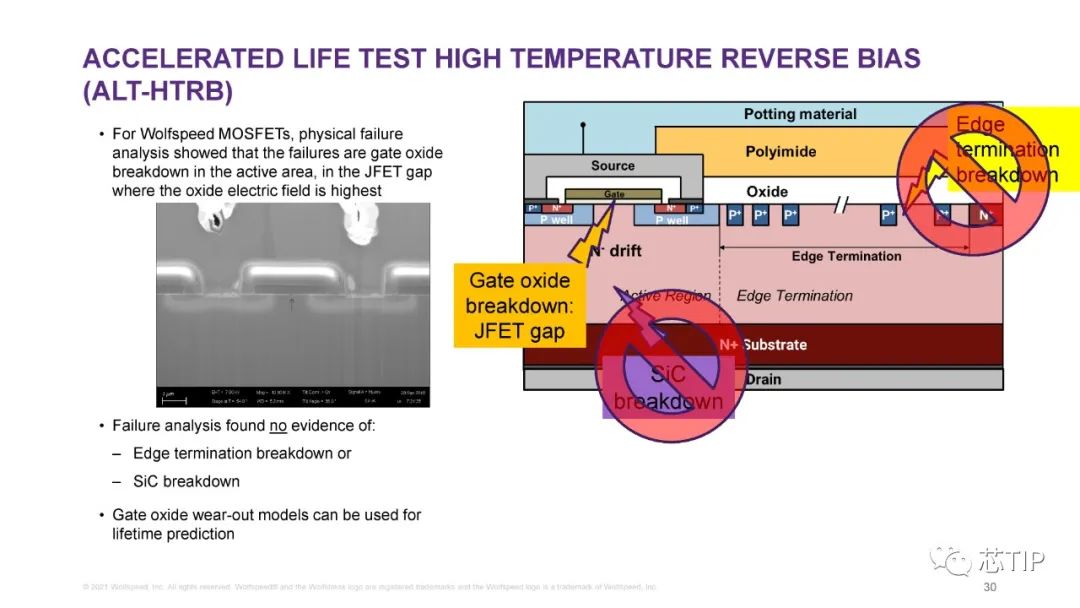
# 湿度相关的可靠性

# 湿度相关的可靠性
• 与湿度有关的可靠性是所有行业标准准则中的一个标准鉴定测试
• Wolfspeed E 系列器件已通过 85C/85%RH 寿命测试,没有腐蚀迹象:
– Gen3 900 V MOSFET
– Gen4 1200 V 肖特基二极管
• SiC 的 THB 加速因子尚未确定,但它们可能与 Si 器件的加速因子相似,因为金属和电介质相似:
– 湿度:Peck 模型(幂律)
- 温度:阿伦尼乌斯热活化
• 具有良好的钝化和器件设计,SiC 的湿度相关可靠性非常好
– 劣质的钝化膜、缺陷和污染可能导致问题出现

# 封装可靠性

# 封装可靠性:功率循环
• 功率循环测试引线键合热机械疲劳磨损
• 使用本文和其他文件中描述的“LESIT 模型”
• 功率循环是芯片金属化和引线键合的特性
• 并非 SiC 独有:类似于 Si IGBT 和模块中发生的情况

# 功率循环

# 针对示例操作条件的功率循环寿命预测

# 宇宙射线 / 中子 / SEB

# 地面中子
• 故障率随时间变化 (FIT):每十亿设备小时故障)
• 故障是突然的,故障前几乎没有退化迹象
• 在中子束设施中根据经验确定的建模以模拟地面中子的影响
加速因素:
• VDS
• 温度(负值——越冷越差!)
• 海拔
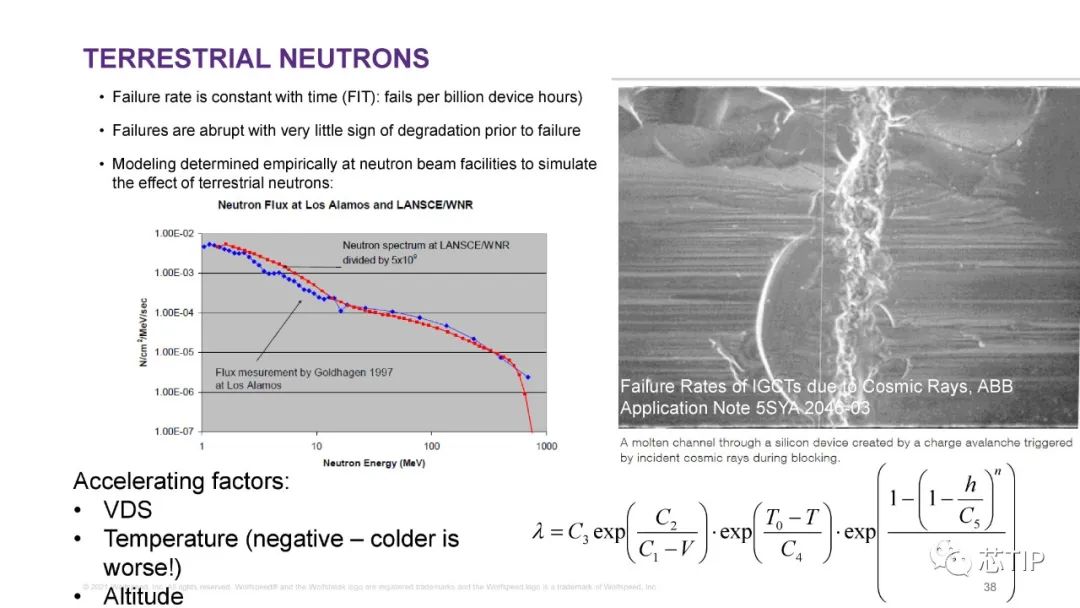
# 地面中子
• Wolfspeed SiC MOSFET FIT 率:按有源面积缩放
• 故障率随器件面积成比例增加
• 故障率随着额定电压的增加而降低
• Wolfspeed MOSFET 的 FIT/cm2 与 VDS对比
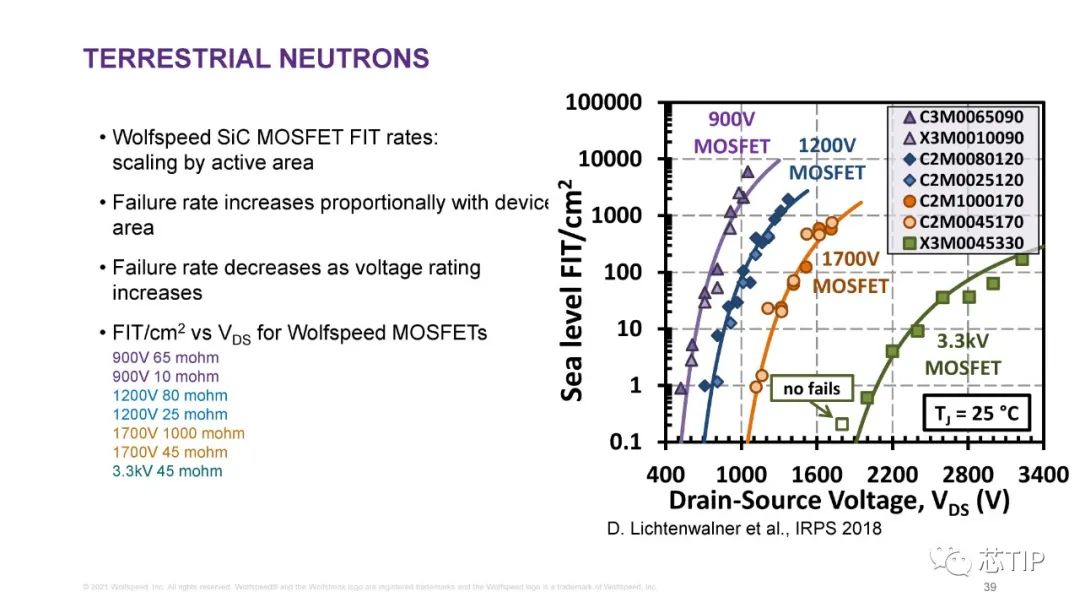
# 地面中子
- 所有器件的FIT率与活动面积和漂移场(相对于雪崩)的比例相似
- 有源区和漂移设计可进行定制,以满足特定应用的系统寿命要求

# 地面中子:MOSFET 和二极管
• MOSFET 和二极管显示出相同的中子可靠性
• 有源面积和漂移效应主导可靠性
• 故障分析未显示 MOSFET 寄生 NPN 导通或栅极氧化层击穿
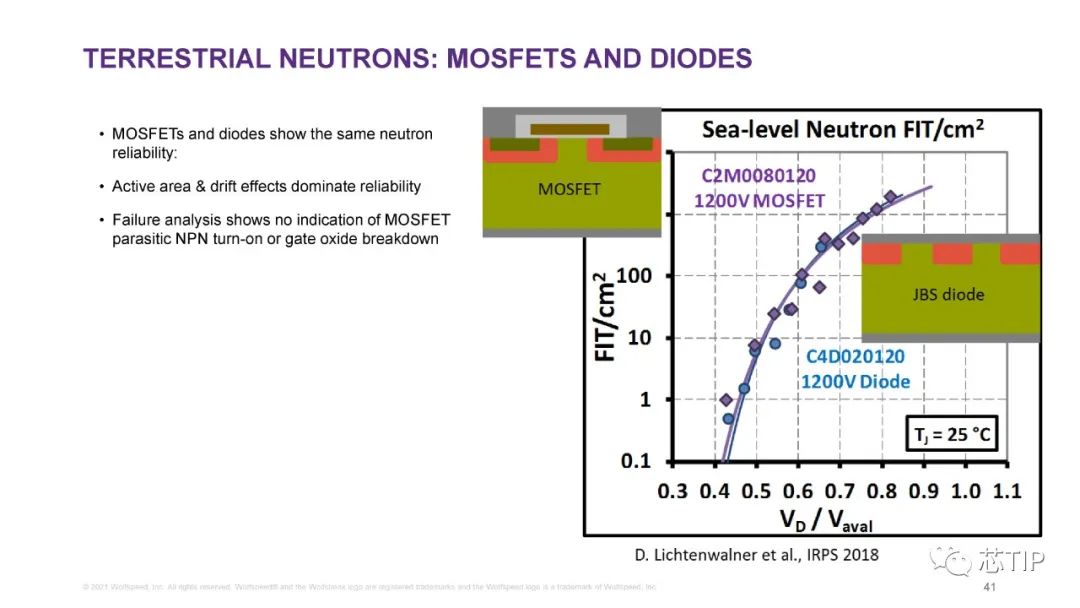
# 地面中子实际失效机制
• 仅观察到与漂移有关的故障
• 无栅极氧化击穿
• 无寄生 NPN 导通

# 地面中子:SiC VS Si
• Si IGBT 表现出更剧烈的故障发生,但最大故障率更高
• SiC 和 Si 部件都可能需要 VDS 降额,但 SiC 更不受 VDS 过冲的影响
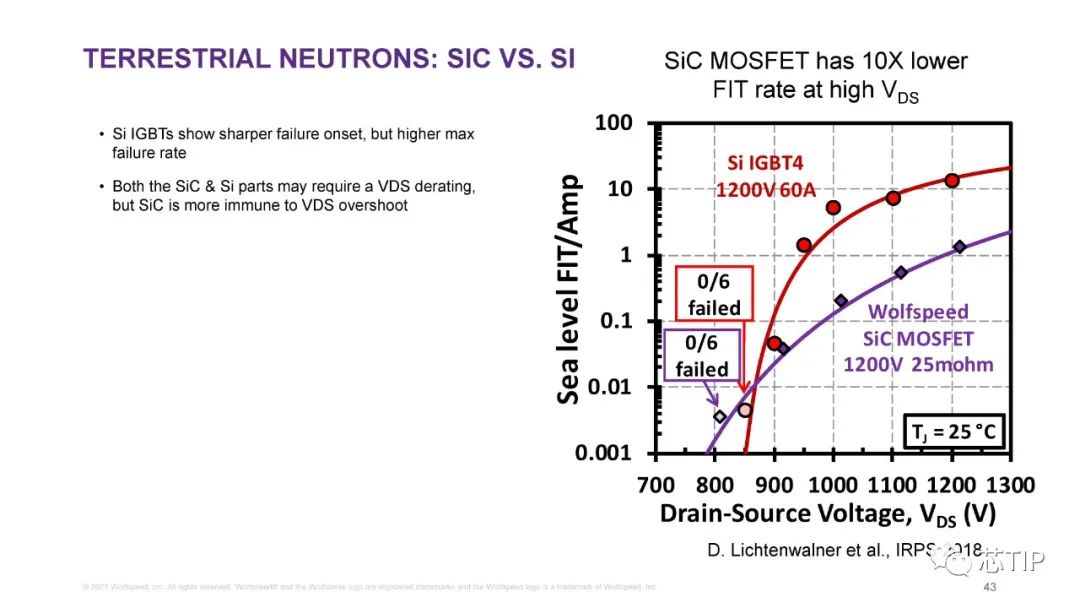
# 栅极电压对中子拟合率没有影响

# 产品认证

# 典型产品

# 典型的 THB-80 评估

# 评估任务概况的方法

# 任务概况和可靠性预测

# 现场可靠性

# WOLFSPEED 功率场可靠性(截至 2021 年 4 月)

# 行业联盟指南和标准


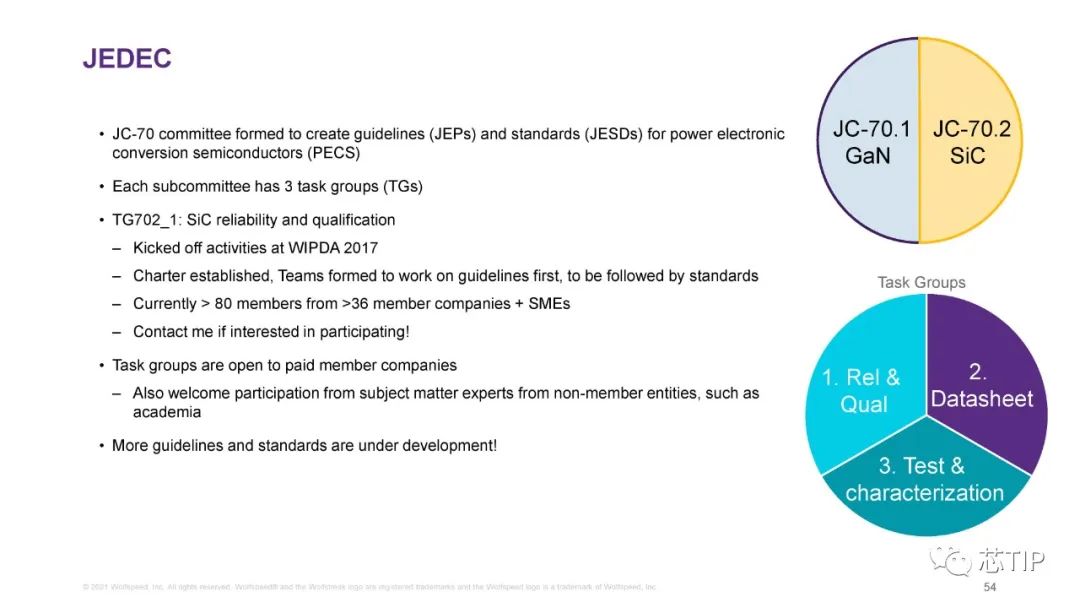

# 总结

# 总结
• SiC 功率器件与 Si 功率器件相比,还有一些独特的可靠性考虑因素
• 可靠性评估需要全面和具体
• SiC 失效机制已确定,测试方法已开发,但仍需开展更多工作
• 成功的产品认证和现场可靠性表明可靠性科学正在取得成效,并且 SiC 已准备好用于高可靠性应用的大批量制造——未来就是现在!
• 正在积极制定行业范围内的可靠性指南和标准

# 作者个人简介:


参考来源:DONALD A. GAJEWSKI
DIRECTOR, RELIABILITY ENGINEERING & FAILURE ANALYSIS
部分编译:芯TIP@吴晰
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。