国庆

中秋
花好月圆 家国团圆

为什么有的芯片是引脚封装,而手机的芯片则是用的底部BGA球珊阵列封装?所谓的芯片其实只有中间很小的一部分仔细看它的结构,芯片是正面朝上内部的电路会连接到四周的凸块 然后再一根一根打线打出比头发丝还要细的金线连接到引脚然后再用外壳沾连保护这种封装又称为打线封装
然后再一根一根打线打出比头发丝还要细的金线连接到引脚然后再用外壳沾连保护这种封装又称为打线封装 随著芯片的功能越多四周引脚数量也要随之增加相应的外壳体积就不得不做得更大如果要做成手机处理器级别的芯片估计光一块芯片体积就得和遥遥领先(华为)差不多大很显然这种封装肯定不合适我们再来看看另一种封装是如何解决体积问题的拆开芯片外壳芯片是正面朝下
随著芯片的功能越多四周引脚数量也要随之增加相应的外壳体积就不得不做得更大如果要做成手机处理器级别的芯片估计光一块芯片体积就得和遥遥领先(华为)差不多大很显然这种封装肯定不合适我们再来看看另一种封装是如何解决体积问题的拆开芯片外壳芯片是正面朝下 然后整面铺满凸块这些凸块紧贴著一块导线载板导线窄板的线路是直接穿孔到另一面然后直入金属球芯片就是通过这些金属球和外部连接对比之前面积变得更小引脚数量可以变得非常多如果是用在手机里的芯片
然后整面铺满凸块这些凸块紧贴著一块导线载板导线窄板的线路是直接穿孔到另一面然后直入金属球芯片就是通过这些金属球和外部连接对比之前面积变得更小引脚数量可以变得非常多如果是用在手机里的芯片
到这一步还不够手机芯片除了核心计算还有存储、基带、其他等等多种模块也就是要将多个模块的芯片实现相互通信并且整合在一个封装里它的原理是将所有芯片模块朝下放很多非常细微的凸块然后接上一块硅中介板利用化学的方法 在硅中介板时刻出线路并且这些线路是穿孔打通线路只有10微米约为头发丝的1/10然后在底部再放金属凸块连接导线载板导线载板的线路同样也是穿孔打通再接上非常多的金属球这一种封装就是2.5D封装目前华为芯片以及其他芯片都是采用这种封装
在硅中介板时刻出线路并且这些线路是穿孔打通线路只有10微米约为头发丝的1/10然后在底部再放金属凸块连接导线载板导线载板的线路同样也是穿孔打通再接上非常多的金属球这一种封装就是2.5D封装目前华为芯片以及其他芯片都是采用这种封装 从实物可以看到背部的金属球非常密集金属球之间的间距也非常窄在焊接电路板的时候稍微有点倾斜金属球非常容易接触焊盘所以手机芯片的焊接环节会采用SMT贴片机
从实物可以看到背部的金属球非常密集金属球之间的间距也非常窄在焊接电路板的时候稍微有点倾斜金属球非常容易接触焊盘所以手机芯片的焊接环节会采用SMT贴片机
 利用机器来识别焊盘的位置精准贴装芯片想要看压在中间的焊盘是否准确对准直接看肯定是看不到的所以SMT工厂会采用S-ray设备它的原理类似于照S光可以清楚看到内部的接触状况透过这个镜头也能清楚看到非常细小的线路
利用机器来识别焊盘的位置精准贴装芯片想要看压在中间的焊盘是否准确对准直接看肯定是看不到的所以SMT工厂会采用S-ray设备它的原理类似于照S光可以清楚看到内部的接触状况透过这个镜头也能清楚看到非常细小的线路
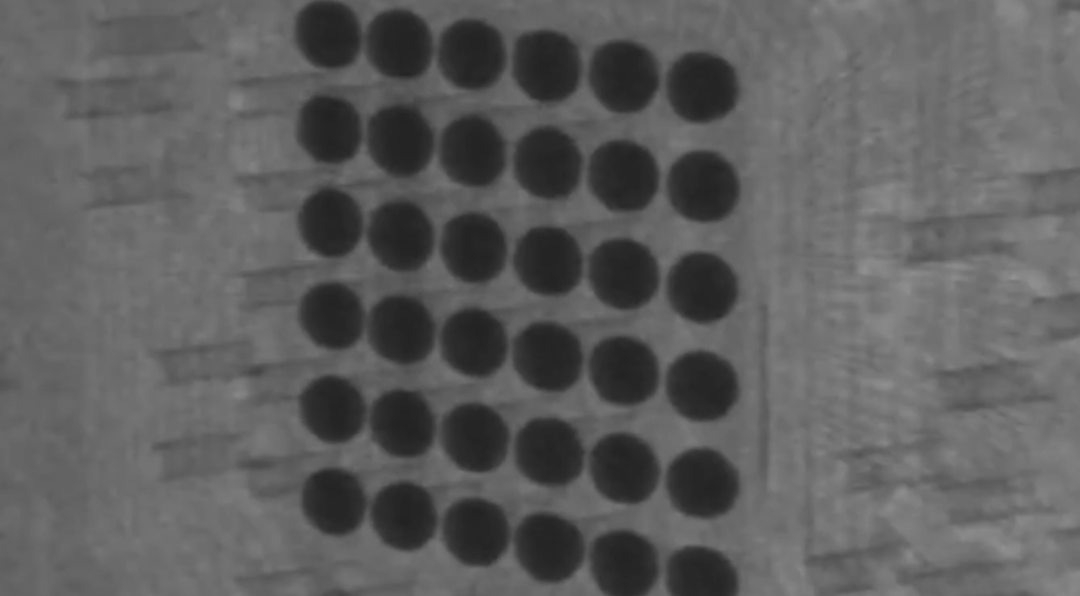 现在主流芯片采用的2.5D封装想要突破无论怎么摆所有芯片模块都是平铺在一个面还有更加突破的技术则是连芯片本身也进行穿孔也就是中间层的芯片本身既保持原功能还要打孔起到上下相通的作用所以要在晶体管时刻阶段就要考虑走线穿孔的问题这个难度非常非常大目前能够做到穿孔的芯片只有一种就是DRAM内存芯片目前已经实现3D封装的芯片是用在摄像头的头像处理芯片
现在主流芯片采用的2.5D封装想要突破无论怎么摆所有芯片模块都是平铺在一个面还有更加突破的技术则是连芯片本身也进行穿孔也就是中间层的芯片本身既保持原功能还要打孔起到上下相通的作用所以要在晶体管时刻阶段就要考虑走线穿孔的问题这个难度非常非常大目前能够做到穿孔的芯片只有一种就是DRAM内存芯片目前已经实现3D封装的芯片是用在摄像头的头像处理芯片 
顶部是用于受光的传感器
中间是DRAM实现中间穿孔
底部则是用于逻辑运算的计算模块
正好组成一组3D封装
所以未来芯片的发展方向
是将所有芯片实现穿孔堆叠在一起
这个难度非常非常难
目前还没能够实现
以上就是芯片的封装原理
公司介绍:
海思半导体是一家半导体公司,海思半导体有限公司成立于2004年10月,前身是创建于1991年的华为集成电路设计中心。海思公司总部位于深圳,在北京、上海、美国硅谷和瑞典设有设计分部。为面向公开市场,海思以其位于上海的分部为基础,于2018年6月成立上海海思技术有限公司 。自此,海思的产品正式在公开市场销售。
海思的产品覆盖无线网络、固定网络、数字媒体等领域的芯片及解决方案,成功应用在全球100多个国家和地区;在数字媒体领域,已推出SoC网络监控芯片及解决方案、可视电话芯片及解决方案、DVB芯片及解决方案和IPTV芯片及解决方案。2019年海思Q1营收达到了17.55亿美元,同比大涨了41%,增速远远高于其他半导体公司,排名也上升到了第14位。
--END--
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。



 随著芯片的功能越多
随著芯片的功能越多